Die Halbleiterprüfung ist ein entscheidender Schritt zur Sicherstellung von Ausbeute und Zuverlässigkeit im gesamten Herstellungsprozess integrierter Schaltkreise. Wissenschaftliche Kameras spielen als zentrale Detektoren eine entscheidende Rolle – ihre Auflösung, Empfindlichkeit, Geschwindigkeit und Zuverlässigkeit wirken sich direkt auf die Fehlererkennung im Mikro- und Nanobereich sowie auf die Stabilität von Prüfsystemen aus. Um den unterschiedlichsten Anwendungsanforderungen gerecht zu werden, bieten wir ein umfassendes Kameraportfolio – von großformatigen Hochgeschwindigkeitsscannern bis hin zu fortschrittlichen TDI-Lösungen, die häufig in der Wafer-Fehlerprüfung, Photolumineszenzprüfung, Wafer-Messtechnik und Verpackungsqualitätskontrolle eingesetzt werden.
-

Gemini 8KTDI Rückwärtig belichtete TDI-sCMOS-Kamera
Spektralbereich: 180–1100 nm
Typische QE: 63,9 % bei 266 nm
Max. Zeilenrate: 1 MHz @ 8 / 10 Bit
TDI-Stufe: 256
Datenschnittstelle: 100G / 40G CoF
Kühlmethode: Luft / FlüssigkeitMehr anzeigen -

Dhyana 9KTDI Pro Rückwärtig belichtete TDI-sCMOS-Kamera
Spektralbereich: 180–1100 nm
Typische QE: 50 % bei 266 nm
Max. Zeilenrate: 600 kHz @ 8 / 10 Bit
TDI-Stufe: 256
Datenschnittstelle: QSFP+
Kühlmethode: Luft / FlüssigkeitMehr anzeigen -

Dhyana 9KTDI Rückwärtig belichtete TDI-sCMOS-Kamera
Spektralbereich: 180–1100 nm
Typische QE: 38 % bei 266 nm
Max. Zeilenrate: 510 kHz @ 8 Bit
TDI-Stufe: 256
Datenschnittstelle: CoaXPress 2.0
Kühlmethode: Luft / FlüssigkeitMehr anzeigen
-
Kann das EMCCD ersetzt werden und würden wir das jemals wollen?
 5460
5460  22.05.2024
22.05.2024 -
Eine Herausforderung für den Flächenscan? Wie TDI Ihre Bilderfassung verzehnfachen kann
 5664
5664  10.10.2023
10.10.2023 -
Beschleunigung der lichtbegrenzten Erfassung mit Line Scan TDI Imaging
 7078
7078  13.07.2022
13.07.2022
-
Verfolgung von Leuchtfeuern in stark trübem Wasser und Anwendung beim Andocken unter Wasser
 1000
1000  31.08.2022
31.08.2022 -
Neuritenwachstum von Trigeminusganglionneuronen in vitro mit Nahinfrarotlichtbestrahlung
 1000
1000  24.08.2022
24.08.2022 -
Hochtemperaturtolerante Pilze und Oomyceten in Korea, einschließlich Saksenaea longicolla sp. nov.
 1000
1000  19.08.2022
19.08.2022

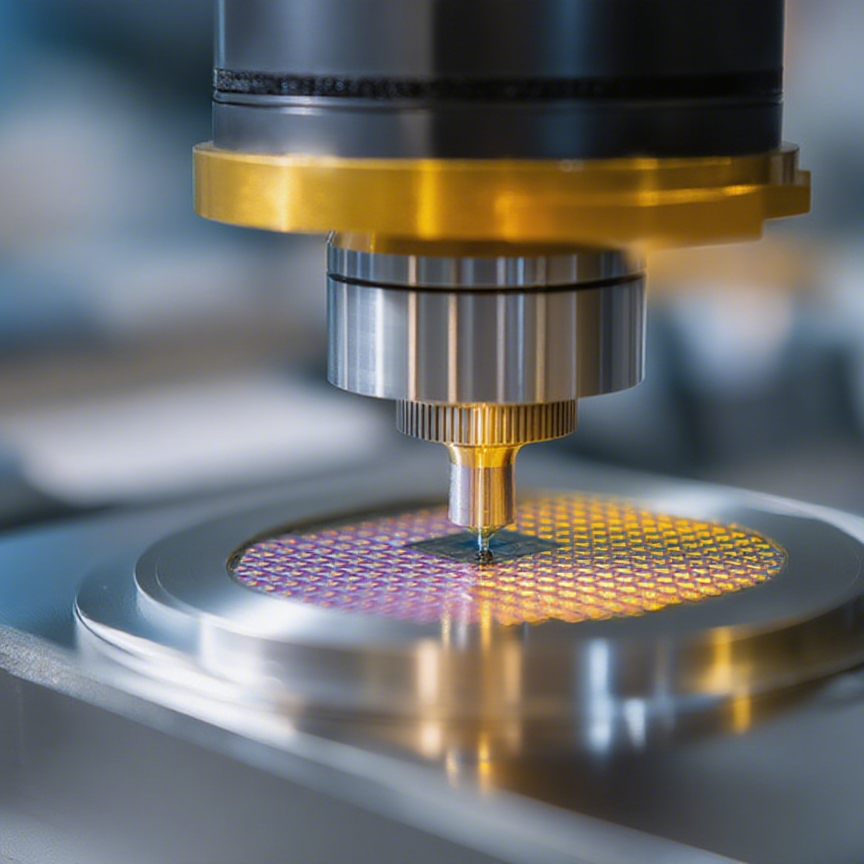

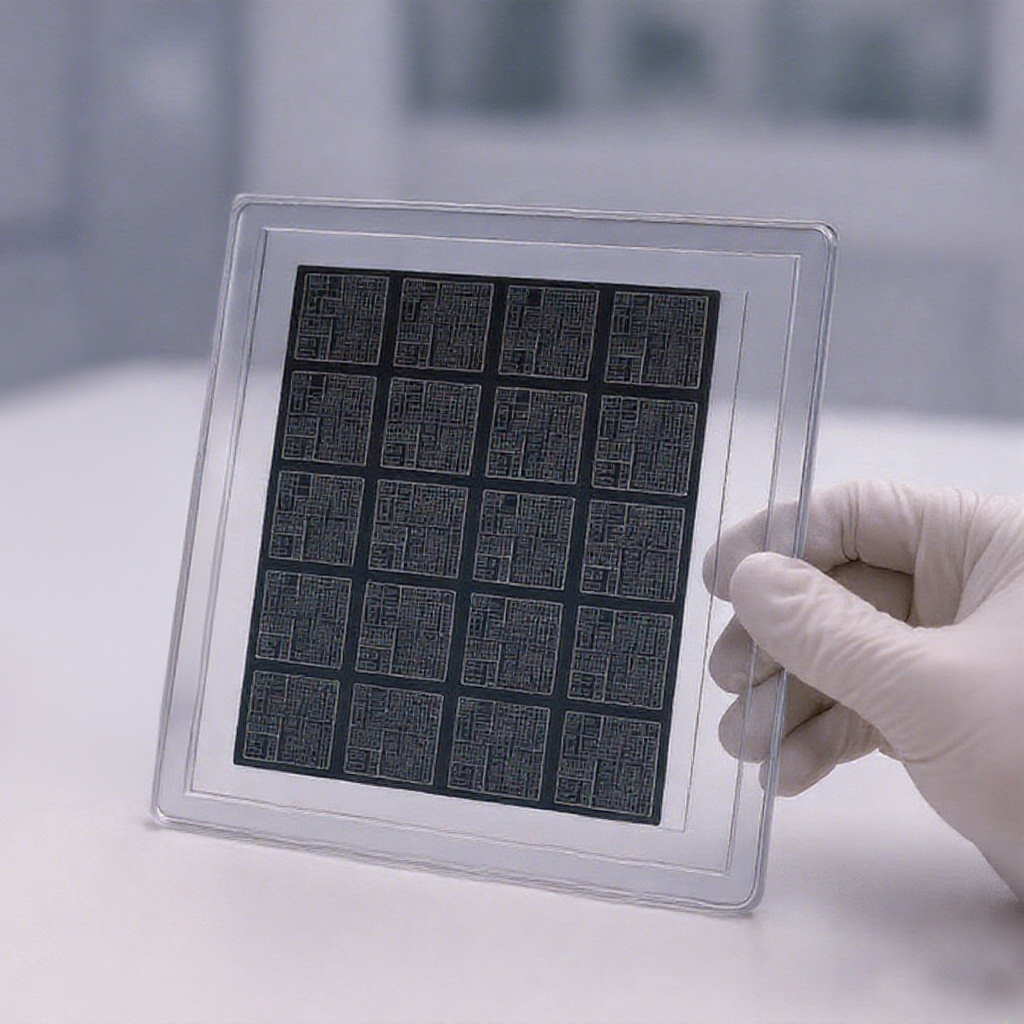

 5460
5460